BGA在電子產品中應用非常普遍,與QFP、QFN、PLCC封裝器件相比,BGA元件具有引腳數目多、引腳間電感及電容更小、引腳共面性好、電性能和散熱性能好等優點。
BGA缺點也十分明顯:BGA在焊接完成之后,由于其焊點全部在器件本體腹底之下,因此既無法采用傳統的目測方法觀測檢驗全部焊點的焊接質量,也不能用AOI對焊點外觀做質量評判,目前通用的方式均采用X-RAY對BGA器件焊點的物理結構進行無損透視檢測。
X-RAY是通過X射線的實時成像技術,實現對BGA焊點的質量檢驗,X射線不能穿透錫、鉛等密度大且厚的物質,所以可形成深色影像,而X射線可以輕易穿透印制板及塑料封裝等密度小且薄的物質,不會形成影像,這樣的現象就可以從影像中判別BGA的焊接質量。
BGA焊點缺陷主要有焊料橋連、焊錫珠、空洞、錯位、開路和焊料球丟失、焊接連接處破裂、虛焊等。
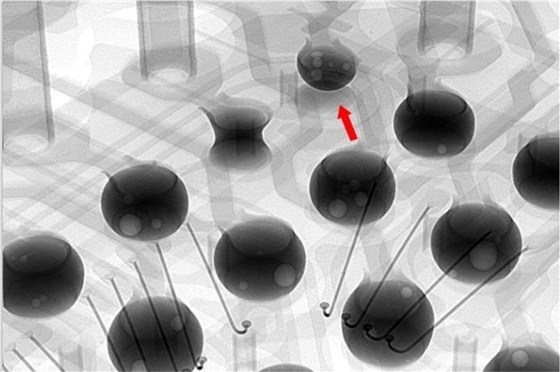

由于焊料橋連最終導致的結果就是電氣短路,因此BGA焊接后,各相鄰錫球之間應無焊料橋連。這種缺陷在采用X-RAY檢驗時比較明顯,在影像區內可見錫球間呈現連續的連接,容易觀察和判斷。虛焊缺陷也可以通過旋轉X射線角度進行檢驗,從而及時采取有效措施避免它的發生。
利用X-RAY對BGA焊接質量進行檢驗是一種高性價比的檢驗手段。隨著新技術的發展,超高分辨率、智能化的X-RAY不僅會為BAG組裝提供省時、省力、可靠的保障,也能夠在電子產品故障分析中扮演重要的角色,提高故障排查效率。
欲了解更多3D X-RAY設備信息可以撥打全國免費熱線:400 9024 816,132 6739 4786電話/微信或訪問安悅科技官網:http://www.eqbzf.com/Products/dgyxlon3dx.html
 咨詢熱線:400-9024-816
咨詢熱線:400-9024-816
 ERSA選擇焊VERSAFLOW3/35
ERSA選擇焊VERSAFLOW3/35 德國YXLON 3D X-RAY Cheetah EVO
德國YXLON 3D X-RAY Cheetah EVO 德國YXLON 3D X-RAY Cougar EVO
德國YXLON 3D X-RAY Cougar EVO ERSA回流焊HOTFLOW3/20
ERSA回流焊HOTFLOW3/20